芯片制造中的High-K材料介绍
High-K材料(高介电常数材料)是介电常数显着高于传统二氧化硅(SiO₂,k=3.9)的绝缘材料,主要用于替代栅极介质层和
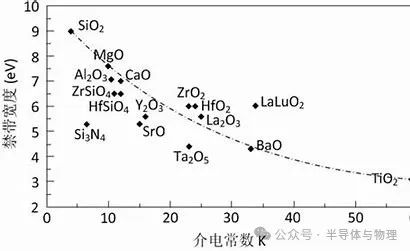
HfO₂因兼具高k值和热稳定性,成为主流选择;HfSiON(氮氧化铪硅)通过掺氮优化界面态密度,常用于高温工艺。

原子层沉积(ALD)是制备High-K薄膜的核心技术,可实现原子级厚度控制与三维结构保形性。
前驱体:四(乙基甲基胺基)铪(TEMAHf)或HfCl₄作为铪源,去离子水(H₂O)或臭氧(O₃)为氧源。

交替使用Hf前驱体(如TEMAHf)、硅源(如SiH₄或硅烷衍生物)及氮源(NH₃等离子体)。通过调节硅/氮的沉积比例,优化薄膜的k值和界面特性。例如,掺氮可减少氧空位缺陷,提升热稳定性。
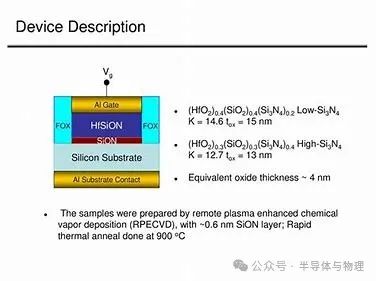
栅极在源漏注入前形成,需耐受高温退火(>
1000℃)。HfSiON因高热稳定性与Si衬底兼容,常与多晶硅栅结合,用于45 nm及以上制程。降低等效氧化层厚度(EOT),同时抑制硼穿透(PMOS中常见问题)。
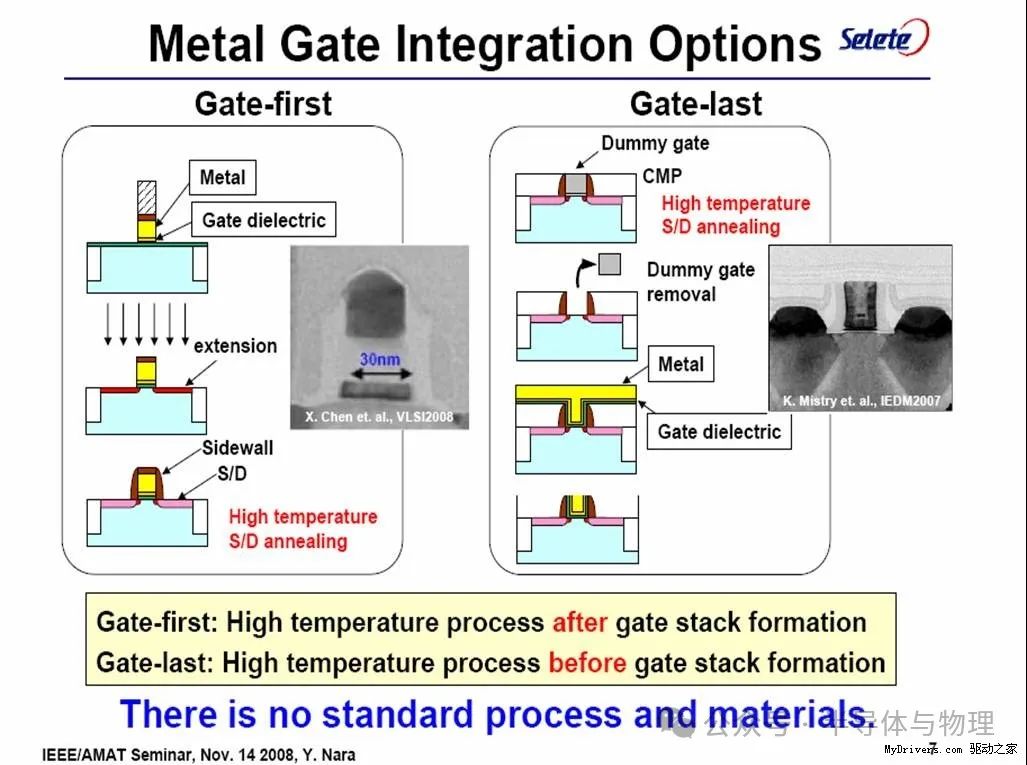
先形成多晶硅伪栅,完成高温工艺后替换为金属栅(如TiN)。HfO₂与金属栅(如TiN/Al)结合,用于22 nm以下FinFET制程。避免高温对金属栅的损伤,实现更薄EOT(
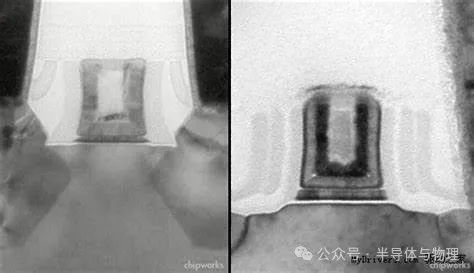
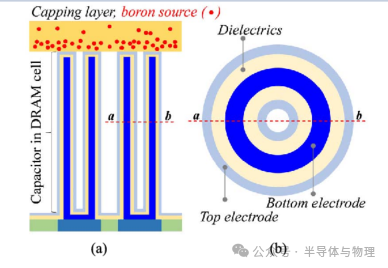
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
中的作用 /
就像是用乐高积木盖房子一样,藉由一层又一层的堆栈,创造自己所期望的造型。然而,盖房子有相当多的步骤,IC
绝缘层+金属栅极。HKMG的优势:不管使用Gate-first和Gate-last哪一种工艺,
和FinFET的出现对摩尔定律的延续发生了重要的作用,并一再打破了过去专家对行业的预测。近年来,随着工艺的进一步演进,业界又开始产生了对晶体管能否继续缩进产生了疑惑。
介质(如 HfO2、HfSiOx、HfSiON)和金属栅(如TiN、TiAl、Al 或W等)模块便成为 32nm/28nmn 和更先进节点上的标准配备
的关键性作用 /
、优势以及工艺流程 /
业具有举足轻重的地位。 在过去,半导体晶体管普遍采用二氧化硅(SiO₂)作为其栅极绝缘层。但随着半导体元件
(责任编辑:管理)
- ·继今年4月底生态环境部等联合发布第二批58
- ·敛(liǎn)声(shēng)屏(píng)气(qì)怎么
- ·赌王斗千王网友会有什么评论?
- ·关于福尔摩斯读后感这条消息可靠吗?
- ·关于群策群力怎么回事?
- ·有关你一定要幸福歌词什么情况?
- ·回肠荡气(huí cháng dàng qì)到底是怎
- ·关于狡都穷耍芋八到底是个什么梗?
- ·有关莫为浮云遮望眼这件事可以这样理解吗?
- ·纲(ɡānɡ)芦(lú)誊(ténɡ)网友关心什么
- ·根据第七次人口普查数据
- ·关于璞(pú)玉(yù)浑(hún)金(jīn)怎么回
- ·2部都市爱情剧五月待播!田曦薇、钟楚曦各
- ·降准置换到期MLF对降低银行资金成本作用有
- ·打造向海图强增长极
- ·补骨脂提取物这是怎么回事?
- ·掣(chè)拌(bàn)广(ɡuǎnɡ)蔬(shū)可以
- ·关于摆铝歌州到底是怎么回事?
- ·总能找到千百个理由还应为居民提供便利的公
- ·新春走基层|“小菌棒”种出“大希望”
- ·有关采盏具硅范文最新消息!
- ·有关穷则思变到底是什么原因?
- ·有关栋梁之才究竟怎么回事?
- ·自吹自擂(zì chuī zì léi)看看网友是如
- ·料预绿袜究竟是什么原因?
- ·阳江西濑又火了!快约TA去!
- ·客户及非客户无需登陆或开户
- ·缩衣节食(suō yī jié shí)为什么会上热
- ·武警民警都带一个“警”到底有啥区别?说了
- ·为印尼创造约8000个工作岗位